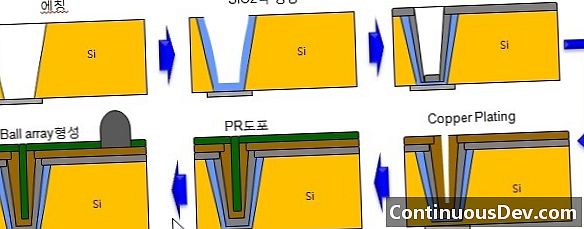
Зміст
- Визначення - Що означає Via-Silicon Via (TSV)?
- Вступ до Microsoft Azure та Microsoft Cloud | У цьому посібнику ви дізнаєтеся, що стосується хмарних обчислень та як Microsoft Azure може допомогти вам мігрувати та вести свій бізнес із хмари.
- Техопедія пояснює через силіцій через (TSV)
Визначення - Що означає Via-Silicon Via (TSV)?
Наскрізний кремній через (TSV) - це тип через (вертикальний взаємозв'язок) з'єднання, який використовується в інженерії та виробництві мікросхем, який повністю проходить крізь кремнієву плашку або пластину, щоб забезпечити укладання кубиків кремнію. TSV є важливим компонентом для створення 3-D пакетів та 3-D інтегральних схем. Цей тип з'єднання працює краще, ніж його альтернативи, такі як пакет-на-пакет, оскільки його щільність вище, а з'єднання коротше.Вступ до Microsoft Azure та Microsoft Cloud | У цьому посібнику ви дізнаєтеся, що стосується хмарних обчислень та як Microsoft Azure може допомогти вам мігрувати та вести свій бізнес із хмари.
Техопедія пояснює через силіцій через (TSV)
Через-кремній через (TSV) використовується для створення 3-D пакетів, що містять більше однієї інтегральної схеми (ІС), вертикально складеної таким чином, що займає менше місця, при цьому все ж дозволяючи забезпечити більшу можливість з'єднання. Перед TSV, 3-D пакети мали складені ІС, з'єднані по краях, що збільшувало довжину і ширину і зазвичай вимагало додаткового «інтерпозарного» шару між ІС, що призводило до набагато більшого пакету. TSV усуває потребу в крайовому проводці та інтерпонентах, що призводить до меншого і більш плоского пакету.Тривимірні ІС - це вертикально складені мікросхеми, схожі на 3-D пакет, але вони виступають як єдине ціле, що дозволяє їм зберігати більше функціональних можливостей у відносно невеликій нозі. TSV додатково покращує це, забезпечуючи короткий швидкісний зв'язок між різними шарами.